 |
|
|
Архитектура Астрономия Аудит Биология Ботаника Бухгалтерский учёт Войное дело Генетика География Геология Дизайн Искусство История Кино Кулинария Культура Литература Математика Медицина Металлургия Мифология Музыка Психология Религия Спорт Строительство Техника Транспорт Туризм Усадьба Физика Фотография Химия Экология Электричество Электроника Энергетика |
Полупроводниковый диод
Полупроводниковым диодом называют двухэлектродный полупроводниковый прибор, содержащий один или несколько электрических переходов (p-n-переходов или переходов металл – полупроводник). Переходы металл – полупроводник называют переходами Шоттки, а полупроводниковые диоды на их основе – диодами Шоттки. Полупроводниковый диод как элемент электрической цепи является нелинейным двухполюсником. Под вольт-амперной характеристикой полупроводникового диода понимают зависимость тока через диод I от приложенного к нему напряжения U. Для вольт-амперной характеристики идеализированного p-n-перехода справедлива следующая формула (уравнение Шокли):
где I0 – обратный ток насыщения; φT – температурный потенциал. Температурный потенциал
где k – постоянная Больцмана (постоянная Больцмана k численно равна работе, которую совершает одна молекула идеального газа при изобарном нагреве на 1 Кельвин, [k] = Дж/К); T – температура по шкале Кельвина; q – заряд электрона. Температурный потенциал имеет размерность напряжения и при комнатной температуре φT ≈ 26 мВ. Уравнение Шокли получено для упрощенной модели реального p-n-перехода при следующих допущениях: · в обеднённом слое нет генерации и рекомбинации носителей; · вне обеднённого слоя электрическое поле отсутствует; · уровень инжекции низкий и ряде других допущений. График идеализированной вольт–амперной характеристики, построенный согласно уравнению Шокли, приведен на рис. 1.10. На характеристике принято выделять прямуюветвь, соответствующую прямому напряжению на p-n-переходе, и обратнуюветвь, соответствующую обратному напряжению на p-n-переходе. Прямое напряжение считается положительным, а обратное – отрицательным. При увеличении прямого напряжения ток резко возрастает: при изменении напряжения на 60 мВ ток изменяется на порядок. При увеличении обратного напряжения обратный ток идеализированного p-n-перехода сначала быстро возрастает до значения I0, а затем остается неизменным. При сделанных допущениях ток I0, который называют также тепловым током, обусловлен термогенерацией неосновных носителей в нейтральных p- и n-областях, прилегающих к обеднённому слою на 2¸3 длины диффузии.
Рис. 1.10. Идеализированная ВАХ p-n-перехода.
Уравнение вольт-амперной характеристики можно разрешить относительно напряжения:
Продифференцировав это соотношение, найдем дифференциальное сопротивление p-n-перехода
При прямом смещении дифференциальное сопротивление rпр уменьшается с ростом тока I. При температуре Т = 300 К и прямом токе I = 1 мА получаем rпр = 26 Ом, а при токе I = 10 мА - rпр = 2,6 Ом, т. е. при прямом смещении дифференциальное сопротивление При обратном напряжении дифференциальное сопротивление перехода rобр резко увеличивается и при I→−I0, rобр → ¥. При выводе аналитического выражения для вольт-амперной характеристики идеализированного p-n-перехода объемное сопротивление базы rб полагалось равным нулю. В реальных p-n-переходах необходимо учитывать объемное сопротивление базы rб, с учетом которого прямое напряжение на реальном p-n-переходе будет больше напряжения на идеализированном p-n-переходе на величину падения напряжения на объемном сопротивлении базы rб. При больших токах из-за сопротивления rб вольт-амперная характеристика p-n-перехода становится почти линейной (рис. 1.11). При высоком уровне инжекции в реальных p-n-переходах наблюдается эффект модуляции сопротивления базы, который заключается в уменьшении сопротивления базы из-за увеличения концентрации неосновных носителей в базе. С учетом эффекта модуляции сопротивления базы rб вольт-амперная характеристика p-n-перехода будет проходить левее характеристики, соответствующей rб = const (рис. 1.11). Рассмотрим влияние температуры на вольт-амперную характеристику прямосмещенного p-n-перехода. С увеличением температуры падение напряжения на p-n-переходе уменьшается. Вольт-амперные характеристики прямосмещенного p-n-перехода, снятые при различных температурах, проходят практически параллельно друг другу (рис. 1.12). Температурный коэффициент напряжения (ТКН) прямосмещённого p-n-перехода.
Рис. 1.11. Прямая ветвь ВАХ p-n перехода с учетом различных факторов.
Увеличение тока через прямосмещенный p-n-переход с ростом температуры объясняется тем, что с ростом температуры уровни Ферми в p- и n-областях стремятся к середине запрещенной зоны. Это приводит к уменьшению потенциального барьера и росту тока через p-n-переход.
Рис. 1.12. Прямая ветвь ВАХ p-n перехода c учетом различных температур.
Рассмотрим обратную ветвь вольт-амперной характеристики реального p-n-перехода. Обратный ток в реальных p-n-переходах имеет три составляющие: · тепловой ток I0; · ток термогенерации; · ток утечки. Тепловой ток I0 обусловлен термогенерацией пар носителей в нейтральных p- и n-областях, прилегающих к обедненному слою на 2¸3 длины диффузии. Эта составляющая обратного тока сильно зависит от температуры и практически не зависит от приложенного напряжения. Тепловой ток учтен в идеализированной модели диода. Ток термогенерации обусловлен генерацией пар носителей под воздействием тепловой энергии непосредственно в самом обедненном слое. Электроны, образующиеся в обедненном слое, будут двигаться в сторону n-области, а дырки – в сторону p-области, образуя ток термогенерации. Ток термогенерации увеличивается с ростом обратного напряжения на переходе из-за увеличения объема объединенного слоя. Эту составляющую обратного тока идеализированная модель p-n-перехода не учитывает. У германиевых p-n-переходов преобладает тепловой ток, а у кремниевых – ток термогенерации. Ток утечки обусловлен проводящими пленками и каналами, которые могут образовываться между p- и n-областями на поверхности кристалла. Ток утечки обычно подчиняется закону Ома и слабо зависит от температуры. На ранних стадиях развития полупроводниковой техники ток утечки был обусловлен загрязнением поверхности кристалла, позже – поверхностными состояниями, связанными с поверхностными дефектами решетки. В настоящее время с этими явлениями научились бороться, и для современных p-n-переходов эта составляющая обратного тока нехарактерна. Ток утечки в идеализированной модели p-n-перехода не учтен. В реальных p-n-переходах при увеличении обратного напряжения наблюдается пробой, под которым понимают резкое увеличение обратного тока. Различают три вида пробоя: тепловой, лавинный и туннельный. Тепловой пробой обусловлен нагреванием p-n-перехода при протекании через него обратного тока. Рост температуры p-n-перехода приводит к росту обратного тока, который приводит к росту температуры и т.д.
Рис. 1.13. Обратная ветвь ВАХ p-n перехода при тепловом пробое.
Если количество теплоты, выделяемой в переходе, превышает количество отводимой теплоты, то этот процесс будет лавинообразно развиваться и закончится разрушением p-n-перехода. Напряжение теплового пробоя тем ниже, чем больше обратный ток и выше температура окружающей среды (рис. 1.13). Этот пробой характерен для германиевых p-n-переходов, но при высокой температуре окружающей среды может наблюдаться и в кремниевых p-n-переходах. Лавинный пробой возникает в p-n-переходах при невысокой степени легирования, когда носители на длине свободного пробега под воздействием электрического поля могут приобрести энергию, достаточную для образования новых пар носителей путем ударной ионизации атомов полупроводника. Напряжение лавинного пробоя очень слабо зависит от тока через p-n-переход (рис. 1.14). Температурный коэффициент напряжения лавинного пробоя положителен, что объясняется уменьшением длины свободного пробега носителей при увеличении температуры. Чтобы при меньшей длине свободного пробега носители приобретали энергию, достаточную для ударной ионизации, требуется большая напряженность электрического поля.
Рис. 1.14. Обратная ветвь ВАХ p-n перехода при лавинном пробое.
Туннельный пробой имеет место в сильно легированных p-n-переходах и связан с туннельным эффектом, под которым понимают переход электронов через тонкий потенциальный барьер без изменения энергии. Туннельные переходы возможны для электронов, энергия которых соответствует интервалу туннелирования Dwтун. (рис. 1.15). Напряжение туннельного пробоя не превышает 5 В и очень слабо зависит от тока через p-n-переход. При повышении температуры напряжение лавинного пробоя уменьшается из-за некоторого уменьшения ширины запрещенной зоны (1.15).
Рис. 1.15. Обратная ветвь ВАХ p-n перехода при туннельном пробое.
Лавинный и туннельный пробой обратимы, если не переходят в тепловой. Лавинный и туннельный пробой как полезные явления используются в стабилитронах. Вольт-амперная характеристика перехода Шоттки описывается тем же уравнением и имеет тот же вид, что и вольт-амперная характеристика p-n-перехода. Отличия вольт-амперной характеристики перехода Шоттки от вольт-амперной характеристики p-n-перехода заключаются в следующем: · обратный ток перехода Шоттки больше, чем у электронно-дырочного перехода; · прямое падение напряжения на переходе Шоттки на 0,2¸0,4 В меньше, чем на p-n-переходе с аналогичными параметрами (рис. 1.16); · прямая ветвь вольт-амперной характеристики реальных переходов Шоттки строго подчиняется экспоненциальному закону в очень широком диапазоне токов – в пределах нескольких декад (например, от 1 пА до 10 мА). Эта особенность связана с отсутствием инжекции неосновных носителей, которая в p-n-переходе приводит к модуляции сопротивления базы, что влияет на вольт-амперную характеристику. Отсюда следует возможность использования перехода Шоттки в качестве прецизионного логарифмирующего элемента.
Рис. 1.16 Прямая ветвь ВАХ обусловленная p-n переходом и переходом Шотки.
Биполярный транзистор
Биполярный транзистор представляет собой систему двух взаимодействующих р-n-переходов. В биполярном транзисторе физические процессы определяются носителями зарядов обоих знаков – основными и неосновными, что отражено в названии транзистора. В зависимости от чередования р- и n-областей различают биполярные транзисторы n-p-n-структуры и p-n-p-структуры (рис.1.17).
Рис. 1.17. Структуры n-p-n и p-n-p переходов.
В изображенном виде транзисторы имеют симметричную структуру. Однако в реальных конструкциях крайние области транзистора имеют существенно разную концентрацию примесей и геометрию. Одна из крайних областей имеет более высокую степень легирования и меньшую площадь. Её называют эмиттером. Другую крайнюю область называют коллектором. Среднюю область транзистора называют базой. Переход, образованный эмиттером и базой, называют эмиттерным переходом, а переход, образованный коллектором и базой, – коллекторным переходом. Взаимодействие между переходами обеспечивается надлежащим выбором толщины базы, которая должна быть много меньше длины диффузии неосновных носителей в базе.
Рис. 1.18. Прямое включение n-p-n транзисторов.
Рассмотрим принцип действия транзистора n-p-n-структуры. Пусть эмиттерный переход транзистора смещён в прямом направлении, а коллекторный – в обратном (рис. 1.18). Поскольку эмиттер легирован намного сильнее базы, то при прямом смещении эмиттерного перехода будет происходить инжекция электронов из эмиттера в базу. Под воздействием градиента концентрации инжектированные электроны будут двигаться по направлению к коллектору. Часть электронов рекомбинирует в базе и образует ток базы IБ. Но поскольку база тонкая, то основная часть электронов дойдет до коллекторного перехода, будет захвачена ускоряющим полем перехода и переброшена в коллектор, создавая ток коллектора. Полный ток коллектора IК складывается из тока электронов, дошедших до коллектора, и обратного тока коллекторного перехода IКБ0, не зависящего от тока эмиттера: IК = α IЭ + IКБ0,
где α – статический коэффициент передачи тока эмиттера. Ток в базе равен разности токов эмиттера и коллектора: IБ = IЭ – IК = IЭ – α IЭ – IКБ0 = (1– α) IЭ – IКБ0.
Как известно, ширина p-n-перехода зависит от напряжения на нем. Рассмотрим следствия изменения ширины эмиттерного и коллекторного переходов транзистора. Изменение ширины эмиттерного перехода при изменении напряжения на нем не оказывает заметного влияния на процессы в транзисторе, так как эмиттерный переход смещен в прямом направлении и, следовательно, узкий, а напряжение на эмиттером переходе изменяется в небольших пределах. Коллекторный же переход смещен в обратном направлении и, следовательно, широкий, а напряжение на нем в процессе работы транзистора может изменяться почти от нуля до напряжения источника питания, поэтому изменение напряжения на коллекторном переходе приводит к заметному изменению ширины коллекторного перехода, а следовательно, и к изменению толщины базы. Явление изменения толщины базы при изменении напряжения на коллекторном переходе называют эффектом модуляции толщины базы или эффектом Эрли (Ирли) по имени Джеймса Эрли (J.M. Earley), впервые описавшего этот эффект в 1952 году.
Рассмотрим следствия эффекта Эрли: · статический коэффициент передачи тока эмиттера α будет зависеть от значения напряжения на коллекторном переходе. Чем больше напряжение на коллекторном переходе, тем больше коэффициент передачи тока эмиттера α; · ток коллектора транзистора будет увеличиваться с ростом коллекторного напряжения: IК = α (UКБ) IЭ + IКБ0; · будет меняться время диффузии дырок через базу, т. е. с ростом напряжения на коллекторном переходе будет повышаться быстродействие транзистора; · будет наблюдаться влияние напряжения на коллекторном переходе на входную цепь транзистора. Если мы будем поддерживать ток эмиттера постоянным, то с увеличением напряжения коллектор-база UКБ напряжение на эмиттерном переходе будет уменьшаться. Такое влияние выходного напряжение на входное называют внутренней обратной связью по напряжению.
Количественно влияние выходной цепи на входную оценивают коэффициентом обратной связи по напряжению. На практике μЭК = 10 –4 ÷10 –3. Транзистор, имеющий входную и выходную цепи, можно рассматривать как четырехполюсник, а так как у транзистора всего три вывода, то один из выводов неизбежно должен быть общим для входной и выходной цепей. В зависимости от того, какой электрод транзистора является общим для входной и выходной цепей, различают три схемы включения транзистора: · с общей базой (ОБ) (рис. 1.19 а); · общим эмиттером (ОЭ) (рис. 1.19 б); · общим коллектором (ОК) (рис. 1.19 в). Независимо от схемы включения транзистор может работать в одном из четырех режимов, отличающихся полярностью напряжений на эмиттерном и коллекторном переходах: · нормальный активный режим: эмиттерный переход включен в прямом направлении, а коллекторный – в обратном; · режим насыщения: оба перехода смещены в прямом направлении; · режим отсечки: оба перехода смещены в обратном направлении; · инверсный активный режим: коллекторный переход смещен в прямом направлении, а эмиттерный – в обратном.
Все четыре режима используются на практике. Нормальный активный режим используется в усилителях. Остальные три режима используются в импульсных и цифровых устройствах. Основными статическими вольт-амперными характеристиками биполярного транзистора являются входные и выходные характеристики. Под входными характеристикамипонимают зависимость входного тока от входного напряжения при постоянном выходном напряжении, являющимся параметром. Под выходными характеристикамипонимают зависимость выходного тока от выходного напряжения при постоянном входном токе, являющимся параметром. Характеристики, снятые при разных значениях параметра, образуют семейство характеристик.
а б в
Рис. 1.19. Возможные схемы включения транзистора: а) схема с общей базой; б) схема с общим эмиттером; в) схема с общим коллектором.
Рассмотрим статические вольт-амперные характеристики биполярного транзистора в схеме с общим эмиттером. В этом случае входная характеристика представляет собой зависимость тока базы IБ от напряжения база-эмиттер UБЭ при постоянном напряжении коллектор-эмиттер UКЭ:
IБ = f (UБЭ); UКЭ = const, а выходная характеристика – зависимость тока коллектора IК от напряжения коллектор-эмиттер UКЭ при постоянном токе базы IБ:
IК = f (UКЭ); IБ = const. Рассмотрим входные характеристики биполярного транзистора в схеме с общим эмиттером (рис. 1.20). Пусть UКЭ = 0. При этом оба перехода смещены в прямом направлении. Транзистор работает в режиме насыщения. Электроны инжектируются в базу как из эмиттера, так и из коллектора. В этом режиме при заданном напряжении база-эмиттер ток базы будет максимальным.
Рис. 1.20. Входные ВАХ характеристики биполярного транзистора в схеме с общим эмиттером
При UКЭ > UБЭ (например, при UКЭ = 1 В) транзистор переходит в нормальный активный режим. В этом режиме ток базы резко уменьшается из-за прекращения инжекции электронов из коллектора. При дальнейшем повышении напряжения коллектор-эмиттер ток базы будет несколько уменьшаться за счет эффекта модуляции толщины базы. (С ростом напряжения коллектор-эмиттер UКЭ уменьшается толщина базы, а следовательно, уменьшается и ток рекомбинации, который является током базы). Поскольку при UКЭ > 1 В входные характеристики транзистора в схеме с общим эмиттером слабо зависят от напряжения коллектор-эмиттер, то в справочниках обычно приводят две характеристики: одну при UКЭ = 0, а вторую – при UКЭ > 1 В. При увеличении температуры входные вольт-амперные характеристики будут смещаться влево с температурным коэффициентом напряжения ТКН ≈ –2 мВ/К. Найдем связь тока коллектора с током базы в нормальном активном режиме: IК = α IЭ+ IКБ0, но IЭ = IК+IБ и тогда IК = α IК+α IБ + IКБ0. Разрешим полученное уравнение относительно тока коллектора:
Величину Если α = 0,9, то β = 9. Если α = 0,99, то β = 99. Если α = 0,999, то β = 999. Таким образом, в схеме с общим эмиттером коэффициент передачи по току β >> 1, в отличие от схемы с общей базой, в которой коэффициент передачи по току α < 1. Выразим статический коэффициент передачи тока базы β через токи транзистора:
С учетом введенного обозначения получим IК = β IБ+ (β + 1) IКБ0. При токе базы IБ = 0 в цепи коллектора протекает обратный ток коллектор-эмиттер IКЭ0 = (β + 1) IКБ0. Рассмотрим выходные вольт-амперные характеристики биполярного транзистора в схеме с общим эмиттером (рис. 2.21). В активном режиме с ростом напряжения коллектор-эмиттер ток коллектора возрастает, что обусловлено эффектом модуляции толщины базы. Угол наклона выходных характеристик к оси абсцисс в схеме с общим эмиттером заметно больше, чем в схеме с общей базой, так как β зависит от напряжения коллектор-эмиттер сильнее, чем α. Отметим на выходных вольт-амперных характеристиках точки, в которых UКЭ = UБЭ, а, следовательно, UКБ = 0. Проведем через эти точки линию, которая будет разграничивать активный режим и режим насыщения. В режиме насыщения по мере уменьшения напряжения коллектор-эмиттер, характер выходных характеристик вначале будет таким же, как и в активном режиме, пока прямое напряжение на коллекторном переходе не достигнет порогового значения, после чего появится ток инжекции коллектора, направленный встречно току инжекции эмиттера. При дальнейшем уменьшении напряжения коллектор-эмиттер UКЭ ток коллектора будет резко уменьшаться и при некотором напряжении
Рис. 1.21. Выходные ВАХ характеристики биполярного транзистора в схеме с общим эмиттером коллектор-эмиттер пересечет ось напряжений. Независимо от тока базы все характеристики пересекают ось напряжений в одной и той же точке
где aI – статический коэффициент передачи тока коллектора в инверсном активном режиме работы транзистора. Это напряжение невелико и составляет десятки милливольт. В справочниках им обычно пренебрегают и рисуют выходные характеристики выходящими из начала координат. В схеме с общим эмиттером выходные характеристики сильно зависят от температуры, смещаясь с ростом температуры вверх, что объясняется увеличением β.
Полевой транзистор
Полевыми транзисторами называют полупроводниковые приборы, работа которых основана на модуляции тонкого полупроводникового канала поперечным электрическим полем. Полевые транзисторы называют также канальными или униполярными, поскольку в них, в отличие от биполярных транзисторов, в образовании электрического тока участвуют носители заряда только одного типа. В зависимости от типа проводимости канала полевые транзисторы могут быть р-канальными и n-канальными. В зависимости от конструкции полевые транзисторы могут быть · с управляющим переходом; · со структурой металл – диэлектрик – полупроводник (МДП-транзисторы). В свою очередь полевые транзисторы с управляющим переходом имеют две разновидности: · с управляющим p-n-переходом; · с управляющим переходом Шоттки. Рассмотрим упрощенную структуру полевого транзистора с управляющим p-n-переходом (рис. 1.22). Полевой транзистор представляет собой пластину слаболегированного полупроводника n-типа, на верхней и нижней гранях которой сформированы области р-типа, образующие с пластиной p-n-переходы. Поскольку степень легирования пластины n-типа значительно меньше степени легирования Подключим к торцам пластины источник напряжения, при этом по каналу в пластине будет протекать ток. Электрод, от которого начинают движение основные носители заряда, называют истоком, а к которому движутся – стоком. Объединенные выводы от р-областей образуют управляющий электрод, называемый затвором.
Рис.1.22. Структура полевого транзистора с управляющим p-n-переходом.
Включим между затвором и истоком источник напряжения, смещающий управляющий p-n-переход в обратном направлении. Принцип действия такого транзистора заключается в том, что при изменении напряжения на затворе изменяется толщина обедненного слоя, а следовательно, изменяется сечение канала, проводимость канала и ток стока, т. е. изменением напряжения на затворе можно управлять током стока. При некотором напряжении затвор-исток обедненные слои сомкнутся, и ток стока станет равным нулю. Это напряжение является параметром транзистора и называется напряжением отсечки UЗИ ОТС. На практике напряжение отсечки определяют не при нулевом токе стока, а при заданном низком значении тока стока. Основными статическими характеристиками полевого транзистора являются выходнаяилистоковая и передаточнаяилистокозатворная. Под выходной характеристикой понимают зависимость тока стока IС от напряжения сток-исток UСИ при постоянном напряжении затвор-исток UЗИ, являющимся параметром: IС = f (UСИ); UЗИ = const. Под передаточной характеристикой понимают зависимость тока стока IС от напряжения затвор-исток UЗИ при постоянном напряжении сток-исток UСИ: IС = f (UЗИ); UСИ = const. Рассмотрим выходные статические характеристики (рис. 1.23). Пусть UЗИ = 0. При небольших напряжениях сток-исток UСИ канал ведет себя как линейное сопротивление. По мере роста напряжения
Рис. 1.23 Выходные характеристики полевого транзистора с управляющим p-n переходом.
Начиная с напряжения UСИ = UЗИ ОТС, в транзисторе будет наблюдаться режим насыщения, при котором рост напряжения сток-исток UСИ сопровождается лишь незначительным ростом тока стока IС. Стабилизация тока стока в режиме насыщения объясняется тем, что рост напряжения сток-исток компенсируется увеличением длины перекрытия канала. Этот эффект называют эффектом модуляции длины канала. При значительном увеличении напряжения сток-исток наблюдается пробой p-n-перехода в области стока. При подаче на затвор отрицательного напряжения исходное сечение канала уменьшается и насыщение наступает раньше, при напряжении UСИ НАС = UЗИ ОТС − UЗИ. При увеличении напряжения затвор-исток (по модулю) на соответствующую величину уменьшается пробивное напряжение сток-исток. Одним из основных параметров полевого транзистора с управляющим переходом является начальный ток стока IС НАЧ, под которым понимают ток стока в режиме насыщения при напряжении затвор-исток UЗИ, равном нулю. Рассмотрим передаточные статические характеристики, снятые для режима насыщения (рис. 1.24). При напряжениях затвор-исток, близких к нулю, передаточная характеристика практически линейна, а при напряжениях затвор-исток, близких к напряжению отсечки, имеет квадратичный характер.
Рис. 1.24. Передаточные статические характеристики для режима насыщения полевого транзистора с управляющим p-n переходом.
Рассмотрим влияние температуры на передаточную характеристику полевого транзистора. При увеличении температуры, с одной стороны, уменьшается контактная разность потенциалов, что приводит к расширению канала и увеличению тока стока, а с другой стороны, уменьшается подвижность носителей в канале, что приводит к уменьшению тока стока. Причем первый фактор преобладает при напряжениях затвор-исток, близких к напряжению отсечки, а второй – при напряжениях затвор-сток, близких к нулю. В результате действия этих противоположных тенденций при некотором напряжении на затворе UЗИ Т, которое называют термостабильной точкой, ток стока не зависит от температуры. При более высокой температуре передаточная характеристика будет иметь вид, показанный пунктирной линией. Термостабильная точка примерно на 0,63 В больше напряжения отсечки UЗИ ОТС. В рабочем режиме в цепи затвора протекает ток обратно смещенного p-n-перехода, который составляет единицы наноампер. Отсюда следует, что полевой транзистор с управляющим переходом имеет высокое входное сопротивление, что является одним из основных его достоинств. В общем случае полевой транзистор является нелинейным элементом, однако при небольших значениях переменных составляющих напряжений и токов полевой транзистор можно считать линейным элементом. В режиме насыщения низкочастотными малосигнальными параметрами полевого транзистора являются: · крутизна
которая характеризует управляющее действие затвора; · дифференциальное сопротивление сток-исток
которое характеризует наклон выходных характеристик в режиме насыщения; · коэффициент усиления по напряжению
Малосигнальные параметры полевого транзистора связаны соотношением
В принципе, возможно три схемы включения полевого транзистора: с общим истоком, общим стоком и общим затвором. На практике последняя схема включения не используется, т. к. в ней теряется основное достоинство полевого транзистора – высокое входное сопротивление. Полевые транзисторы, имеющие структуру металл–диэлектрик–полупроводник, называют МДП–транзисторами. В частном случае, когда в качестве диэлектрика используют оксид, МДП–транзисторы называют также МОП–транзисторами.
Рис. 1.25. МДП транзистора с индуцированным каналом
Существует две разновидности МДП–транзисторов: транзисторы с индуцированным каналом, в которых канал образуется под воздействием внешнего напряжения, и транзисторы со встроенным каналом, в которых канал формируется при изготовлении транзисторов. Рассмотрим реальную структуру МДП–транзистора с индуцированным n-каналом (рис. 1.25). За основу транзистора берётся пластина слаболегированного кремния р-типа, в приповерхностном слое которой методами диффузии или ионной имплантации формируют сильнолегированные области n+-типа. Каждая из этих областей может использоваться как исток или как сток транзистора. Затем на поверхности пластины формируют тонкий (меньше 0,1 мкм) слой диэлектрика, в качестве которого обычно используют диоксид кремния SiO2. Далее над областями n+-типа в диэлектрике вскрывают окна и выполняют омические контакты, которые будут выводами истока и стока. Одновременно с этим формируют затвор транзистора, ширина которого должна быть несколько больше расстояния между областями n+-типа. Подложку обычно соединяют с истоком или делают от неё отдельный вывод. Рассмотрим принцип действия МДП–транзистора с индуцированным каналом. Пусть напряжение UЗИ = 0. Если между истоком и стоком включить источник напряжения, то в цепи стока будет протекать незначительный ток обратносмещенного р-n-перехода, образованного n+-областью стока и подложкой. Если на затвор подать отрицательное напряжение, то поверхностный слой обогатится дырками, но это не повлияет на ток стока. Подадим на затвор положительное напряжение, которое будем увеличивать. При положительном напряжении на затворе электроны из р-полупроводника будут притягиваться к поверхности под затвором. Эти электроны будут рекомбинировать с дырками, и в приповерхностном слое образуется обеднённый слой, представляющий собой объемный заряд отрицательных ионов акцепторной примеси. При дальнейшем увеличении положительного напряжения на затворе концентрация электронов в приповерхностном слое превысит концентрацию дырок, т.е. произойдет инверсия типа проводимости приповерхностного слоя. После образования под затвором проводящего канала n-типа появится ток стока, значение которого будет зависеть от напряжения на затворе. Канал, отсутствующий в равновесном состоянии и образующийся под воздействием внешнего напряжения, называют индуцированным. Напряжение на затворе, при котором образуется канал, называют пороговым напряжением и обозначают UЗИ ПОР. После образования канала его толщина (1÷2 нм) при дальнейшем увеличении напряжения на затворе практически не изменяется. Модуляция проводимости канала при напряжениях на затворе больше порогового объясняется изменением концентрации подвижных носителей в канале. Если в рассмотренной конструкции изменить тип проводимости полупроводниковых областей на противоположный, то получим МДП–транзистор с индуцированным р-каналом. Рабочие напряжения на стоке и затворе МДП–транзистора с индуцированным р-каналом будут отрицательными. Рассмотрим выходные статические характеристики МДП–транзистора с индуцированным каналом (рис. 1.26). Пусть к затвору приложено напряжение выше порогового. При малых напряжениях сток-исток МДП–транзистор ведет себя как линейный резистор, сопротивление которого обратно пропорционально напряжению затвор–исток. По мере роста напряжения сток–исток напряжение между затвором и подложкой будет убывать в направлении к стоку. Соответственно будет уменьшаться и проводимость канала, что приведет к замедлению роста тока стока. При напряжении UСИ = UЗИ – UЗИ ПОР, при котором у стокового конца затвора напряжение между затвором и подложкой станет равным пороговому, обедненный слой выйдет к поверхности полупроводника и канал перекроется. Это напряжение называют напряжением насыщения. Дальнейшее увеличение напряжения сток–исток будет сопровождаться ростом длины перекрытой части канала (эффект модуляции длины канала) и ток стока будет лишь незначительно возрастать.
Рис. 1.26. Выходные характеристики МДП транзистора с индуцированным каналом
При уменьшении напряжения на затворе режим насыщения будет наступать раньше. Выходные характеристики МДП–транзисторов неэквидистантны: с ростом напряжения затвор–исток приращения тока стока увеличиваются. Рассмотрим передаточные статические характеристики МДП–транзисторов (рис. 1.27). При напряжениях сток–исток, соответствующих пологой области выходных характеристик (режим насыщения), передаточные характеристики почти квадратичны. При малых напряжениях сток–исток, соответствующих крутой области выходных характеристик, передаточные характеристики практически линейны. До сих пор мы считали, что подложка соединена с истоком. Если подложка имеет отдельный вывод, то, изменяя напряжение на подложке, можно также управлять током стока. В этом случае управление МДП–транзистором аналогично управлению полевым транзистором с управляющим р-n-переходом.
Рис. 1.27. Придаточная характеристика МДП транзистора и индуцированным каналом.
В интегральных микросхемах подложка является общей для всех МДП–транзисторов. Для уменьшения связей между транзисторами в микросхеме на подложку подают отрицательное напряжение, которое является обратным для переходов подложка–исток, подложка–канал и подложка–сток. Это напряжение расширяет обедненный слой, что приводит к уменьшению напряженности поперечного поля в канале и увеличению порогового напряжения. Таким образом, отрицательное напряжение на подложке сдвигает передаточные характеристики вправо. МДП-транзисторы характеризуются теми же малосигнальными параметрами, что и полевые транзисторы с управляющим переходом: крутизной S, дифференциальным сопротивлением сток–исток rСИ и коэффициентом усиления μ.
Поиск по сайту: |
 ,
, ,
,
 .
. .
.


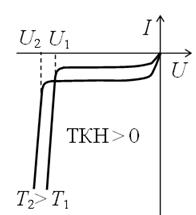







 .
. называют статическим коэффициентом передачи тока базы.
называют статическим коэффициентом передачи тока базы. .
. .
.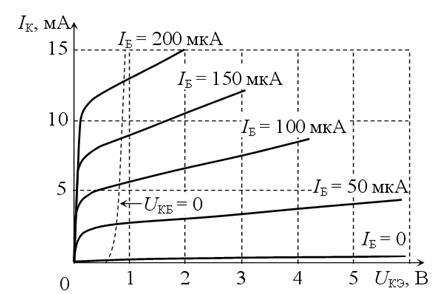
 ,
,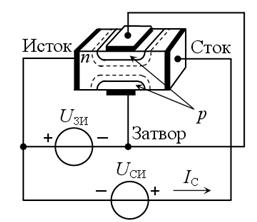

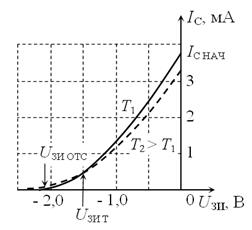
 ,
, ,
, .
. .
.